

3nm制程芯片已经开始量产,2nm将于2025年试产,接下来的1nm将是纳米时代的最后一个节点,为此,业界龙头企业和机构都在摩拳擦掌。
作者:畅秋
2022年,半导体业进入了3nm制程量产阶段,上半年,三星宣布量产3nm芯片,但客户和产量很有限,下半年,台积电也开始量产3nm芯片,但也只限于苹果的一部分新手机处理器,与三星类似,台积电也没有在第一年实现大规模量产。3nm制程芯片产量如何,就要看三星和台积电2023年升级版本的性能和良率表现了。
3nm量产如此艰难,接下来的2nm、1nm节点将更具挑战性,特别是1nm,它达到了纳米级制程节点的极限,再向前演进,就是埃(A,1nm=10A)了。因此,谁能做好1nm制程工艺的研发和量产,并在业界首先推出,将具有很强的象征意义。
按照IMEC(比利时微电子中心)规划的发展路线图,预计2028年可实现1nm制程工艺量产,2030年是A7(0.7nm),之后分别是A5、A3、A2制程。

不过,真正决定工艺密度的金属栅极距指标变化没有工艺数字那么大,甚至A7到A2制程工艺都是在16nm-12nm之间,密度可能没太多提升。而且,到达1nm节点附近时,所产生的量子隧穿效应有可能让传统的半导体工艺失效。
此外,要实现1nm及以下制程工艺,晶体管架构也要改变,三星和台积电分别在3nm、2nm节点放弃了FinFET,转向GAAFET结构,而1nm之后,业界将普遍转向CFET晶体管结构。不止晶体管,还有其它相关技术也要升级,例如布线、光刻机等,需要一系列技术突破才有可能实现。
新晶体管架构
三星3nm采用的晶体管架构是GAAFET,也被称为Nanosheet,而1nm制程对晶体管架构提出了更高的要求。IMEC提出了Forksheet,在这种架构中,sheet由叉形栅极结构控制,在栅极图案化之前,通过在PMOS和NMOS之间引入介电层来实现,这个介电层从物理上隔离了P栅沟槽和N栅沟槽,使得N-to-P间距比FinFET或Nanosheet更紧密。通过仿真,IMEC预计Forksheet具有理想的面积和性能微缩性,以及更低的寄生电容。
此外,3D“互补FET”(CFET)也是1nm制程的晶体管方案。CFET技术的一个显着特征是与纳米片拓扑结构具有很强的相似性。CFET的新颖之处在于PFET和NFET纳米片的垂直放置。CFET拓扑利用了典型的CMOS逻辑应用,其中将公共输入信号施加到NFET和PFET的栅极。
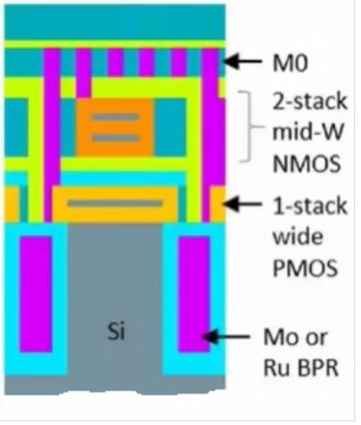
CFET架构需要特别注意PFET和NFET的形成。用于PFET源/漏极的SiGe外延生长用于在沟道中引入压缩应变,以提高空穴迁移率,然后执行PFET栅极氧化物和金属栅极沉积,随后,NFET源极/漏极节点的外延Si生长,随后的栅极氧化物和金属栅极沉积必须遵守现有PFET器件施加的材料化学约束。
新材料工艺
在先进制程芯片的制造过程中,前道工序负责制造出相应结构的晶体管,而中间工序和后道工序则是将这些独立的晶体管连接起来,从而实现相应的芯片功能和性能,这就需要用到各种半导体材料。
1nm制程需要新的晶体管架构支持,如Forksheet和CFET,它们对局部互连提出了更高的要求,相应地,后道工序需要采用新型材料(如钌(Ru)、钼(Mo)等),还需要降低中间工序的接触电阻。
对于后道工序而言,金属线和通孔的电阻和电容仍然是最关键的参数,解决这个问题的一种方法是采用另一种金属化结构,称为“零通孔混合高度”。这种方案可以根据金属线的应用需求,灵活地将电阻换成电容。
为了满足新晶体管结构的要求,同时进一步缓解布线拥挤状况,中间工序需要进一步创新,例如,在CFET中,需要为接触栅极提供新的解决方案。此外,高纵横比的通孔把各种构件互连起来,目前,这些构件已经扩展到三维(3D),但是,需要降低这些深通孔的寄生电阻,这可以通过引入先进的触点来实现,例如使用钌。
过去,芯片制造多使用三维材料,近些年,在以台积电和英特尔为代表的龙头厂商引领下,二维(2D)材料逐渐进入主流行列。
2021年,台积电与中国台湾大学和美国麻省理工学院(MIT)合作,发现了二维材料结合半金属铋(Bi)能实现极低的电阻,接近量子极限,可以满足1nm制程的需求。二维材料厚度可小于1nm,更逼近固态半导体材料厚度的极限,而半金属铋的特性,能消除与二维半导体接面的能量障碍,且沉积时,不会破坏二维材料的原子结构。这样,通过仅1 ~3层原子厚度(小于1nm)的二维材料,电子从源极(source)走以二硫化钼为材料的电子通道层,上方有栅极(gate)加电压来控制,再从漏极(drain)流出,用铋作为接触电极,可以大幅降低电阻并提高传输电流,使得二维材料在1nm制程工艺实施过程中成为取代硅的新型半导体材料。
最近,悉尼新南威尔士大学材料与制造研究所(MMFI)的研究人员使用独立式单晶钛酸锶(STO)膜制造了一系列透明场效应晶体管,其性能与当前的硅半导体场效应晶体管相当。该半导体材料工艺克服了硅在小型化方面的限制,同时展示了大规模制造2D场效应晶体管的潜力,克服了纳米级硅半导体生产的挑战,并提供了可靠的电容和有效的开关操作。
据研发人员介绍,这项工作的关键创新是,将传统的3D散装材料转变为准2D形式,而不会降低其性能,这意味着它可以像乐高积木一样与其它材料自由组装,为各种新兴和未被发现的应用创建高性能晶体管。
此外,在1nm制程芯片中,金属互连带来的焦耳热效应是一个重要考量因素,这方面,IMEC提出了新的解决方案。1nm制程需要在后端最关键的层引入新的导体材料,如二元和三元金属间化合物(Al或Ru化合物),其电阻率低于按比例尺寸的常规元素金属(例如 Cu、Co、Mo 或 Ru)。IMEC通过实验研究了铝化物薄膜的电阻率,包括 AlNi、Al3Sc、AlCu 和 Al2Cu,在20nm 及以上厚度时,所有 PVD 沉积膜的电阻率与 Ru 或 Mo 相当或更低,28nm的AlCu和Al2Cu膜的最低电阻率为9.5 µΩcmCu,低于Cu。
台积电引领1nm研发
在先进制程的研发和商业化方面,台积电一直是行业先锋,1nm自然不会例外。
如上文所述,台积电、中国台湾大学和MIT联合研发的使用半金属铋作为二维材料的接触电极,不仅降低了电阻,还增加了电流,从而大幅提升了能效。不过,该材料工艺还处于研发阶段,未用于量产,为了使用半金属铋作为晶体管的接触电极,不得不使用氦离子束 (HIB) 光刻系统并设计一种“简单的沉积工艺”。这种工艺仅用于研发生产线,因此还没有完全准备好进行大规模生产。
目前,台积电的 1nm 制程节点仍处于探索阶段,工厂正在尝试各种选项,也不能保证未来量产时确定使用半金属铋。
目前,台积电先进制程产线使用钨互连晶体管,而英特尔使用钴互连。两者都有各自优点,并且都需要特定的设备和工具。
不久前,有消息传出,台积电在完成3nm制程工艺研发之后,已经于今年6月把该团队转向了未来的1.4nm工艺研发。
除了台积电,三星和IBM也在进行1nm制程工艺的研发。
当下的集成电路,特别是处理器,晶体管是平放在硅表面上的,电流从一侧流向另一侧。2021年,IBM和三星公布了一种在芯片上垂直堆叠晶体管的设计方法,称为垂直传输场效应晶体管 (VerTIcalTransport Field Effect Transistors,VTFET)。与常规设计相比,VTFET彼此垂直,电流垂直流动。该技术有望突破1nm制程工艺瓶颈。
IBM和三星表示,这种设计有两个优点:首先,它可以绕过许多性能限制,将摩尔定律扩展到纳米片技术之外,更重要的是,由于电流更大,该设计减少了能源消耗,估计VTFET将使处理器的速度比采用 FinFET 晶体管设计的芯片快两倍或功耗降低 85%。
英特尔也于2021年表示,计划在2024年之前跨越1nm,完成埃级芯片设计,据悉,英特尔将使用其新的“Intel 20A”制程节点和 RibbonFET 晶体管来实现这一目标。
光刻机成为关键
除了晶体管架构和材料工艺,要实现1nm制程芯片的量产,EUV光刻机依然是成功的关键。
作为全球唯一一家EUV光刻机供应商,ASML一直是台积电、三星和英特尔关注的焦点。目前,ASML出货的先进EUV光刻机是NXE:3400B、3400C和3600D,这几款机型的数值孔径(NA)均为0.33。其中,3600D在30mJ/cm2下的晶圆吞吐量达到160片,比3400C提高了18%,它将成为台积电和三星3nm制程产线的主要设备。
据悉,IMEC和ASML合作的EUV设备研发工作正在进行,日本的 TEL也参与其中,预计测试设备有望在2023年初完成。
ASML还公布了未来三代光刻机的研发计划,三款机型的型号分别是NEXT:5000、EXE:5000 和EXE:5200。从EXE:5000开始,数值孔径提高到了0.55。
与0.33NA相比,0.55NA设备在多方面都有很大提升,包括更高的对比度,图像曝光成本更低等,是未来发展的趋势。
现在,用于生产5nm/7nm制程芯片的光刻机设备零件数量超过10万个,运输时需要40个货柜,据悉,制造1nm芯片的光刻机体积比3nm的多出一倍。由于光刻机拥有非常多的零件,需要高精度的装配,导致光刻机从发货到配置/培训的整个流程需要两年时间,这样算来,预计0.55NA光刻机的大规模应用要到2025~2026年,乐观估计,那时,业界开始试产1nm制程工艺了。