

引言
在所有金属污染物中,铁和铜被认为是最有问题的。它们不仅可以很容易地从未优化的工艺工具和低质量的气体和化学物质转移到晶片上,而旦还会大大降低硅器件的产量。用微波光电导衰减和表面光电压研究了p型和n型硅中微量铁和铜的影响。这些晶片受到了与超大规模集成技术相关的受控量的铁和铜表面污染。衬底掺杂类型对金属杂质的影响很大。正如所料,Fe会大大降低p型衬底的少数载流子寿命。另一方面,铁对n型硅的影响至少比p型低一个数量级。相比之下,铜对n型材料非常有害,但对于所研究的污染水平,对p型硅的少数载流子特性没有显著影响。
实验
首先,对p型硅中铁污染情况的表征技术进行了全面的研究。为此,CZ、p型、<100>、6至10和24至36±2cm、125mm直径的硅片,含中氧含量,从铁添加(0.25:1:5)NH4OH:H、O、:H、O(SC1)溶液中得到均匀的Fe污染。通过气相沉积得到的铁表面浓度。表面N2环境中热处理30分钟,污染物被驱入晶片。氧化环 境中处理的升温是在5%氧气中进行的。在N2所有情况下的冷却都以5℃/分钟的速度进行到650 ℃,然后在 10分钟内将样品从毛皮中取出至室温。
我们还进行了第二组实验,其中同时使用n型和p型底物(表1)来解决掺杂类型对硅中杂质活性的影响。如前所述,从添加的SC1溶液中以控制和均匀的方式沉积。铜从稀释的HC1(1:l0)溶液中转移到疏水晶片中。

表1 在第二组MCLT研究中使用的底物的描述
为了证明该方法,在图中1,低质量CZ和高质量FZp型晶圆的有效寿命是钝化后所经过的时间的函数。在比较这些CZ和FZ晶片时,可以观察到TPCD的初始值之间的明显差异。FZ晶圆的寿命是CZ晶圆的高两到三倍。这可能与这些特定的CZ样品组中存在的内在缺陷或污染有关。高频处理后的表面钝化在洁净室内空气中相对稳定。在高频钝化后,低表面重组速度可以保持至少5小时。这与观察到的终止氢的表面一致,表面钝化保持完整的几个小时。

图1 非污染p型直拉和FZ晶片HF钝化后,少数载流子寿命由 uPCD测量,作为暴露于洁净室内空气的时间的函数
结果与讨论
对铁污染的p型硅的PCD和SPV结果DLTS测量表明,在退火1周后,所有的铁都与B配对,即使是对高度污染的样品。DLTS只能检测到与FeB对相关的E+0.1eV的特征峰。当由SPV测定的大块硅中的铁浓度作为VPD-DSE-TXRF测量的初始铁表面污染的函数绘制时,所有退火环境都有良好的相关性,见图2。
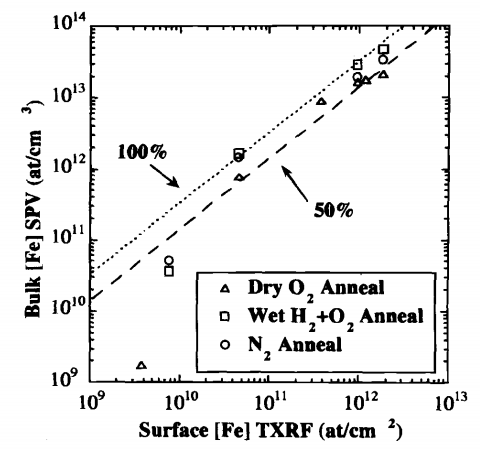
图2 p型直拉样品在不同环境下于90CTC退火30分钟,用表面光 电压测量体硅中的铁浓度,作为退火前铁表面浓度的函数
驱动入衬底的铁的数量取决于退火过程中使用的环境。在干燥时,大约50%的表面铁污染被纳入基质中。使用氮环境导致70-100%的表面污染扩散。这可以理解为这样一个事实:在惰性环境中,大部分的表面污染可以扩散到体中,而在干燥的氧化环境中,铁的部分通过生长的氧化层从体中分离出来。当晶圆在湿氧化环境中退火时,几乎100%的表面污染被包含在体积中。在干燥和湿的氧化环境中,退火过程中铁污染行为的差异可能是由于湿的氧化过程中H的存在造成的。
在图3中,说明了表面钝化对p测量的MCLT的影响。在这种情况下,晶片预计具有较差的表面钝化,因此,对于低于1012原子/cm³的体积[Fe],测量的寿命受到表面重组速度的限制,并且其值在约为10p.s时饱和。具有表面氧化物层的类似污染水平的样品显示出更高的MCLT值,因为在这种情况下,表面重组不是一个限制因素,体积寿命仍然主导结果。体积[Fe]高于1012原子/cm2的晶片具有低体积MCLT,即使在表面钝化程度较差的晶圆中也占主导地位。
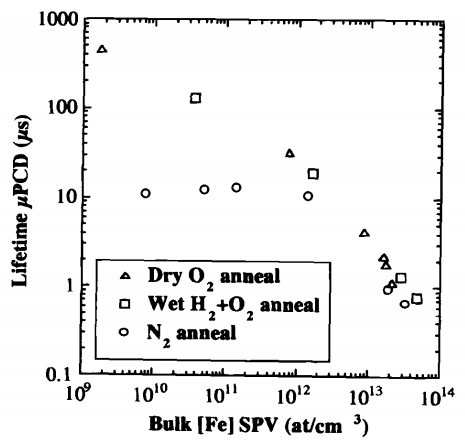
图3 在去除表面氧化物钝化之前和之后,用SPV在p型直拉晶片上测量扩散长度
更详细的研究,有效寿命的行为,由p。PCD作为SPV测定的体积中铁含量的函数。从图3中得到的值。为在干燥和湿氧化环境下退火的晶片,并补充了整个铁污染范围的测量,特别是在低浓度部分,只有干的和湿的氧化环境被用来驱动污染进入基质,以优化样品的表面钝化。
总结
用微波光导衰减(ttPCD)和表面光电压(SPy)研究了p型和n型硅中微量铁和铜的影响。我们观察到,从表面污染中来看,在衬底中加入的铁的量取决于退火环境。退火环境也会影响样品表面钝化,这是测量μPCD低污染晶片的关键参数。在高频溶液中的处理可以用于降低衬底的表面重组速度,允许研究非退火的样品。
衬底掺杂型对金属杂质的重组活性有很大的影响。与预期的那样,Fe降解了p型底物中的少数载流子性质。另一方面,铁对n型硅的影响至少比对p型硅的影响低一个数量级。散装硅中铁污染的可容忍极限将由p型材料的期望性能决定。相比之下,铜对n型材料高度有害,但对p型硅污染高达5倍io原子/cm2的p型硅的微载流子性能没有显著影响。如果n型硅需要良好的性能,则需要控制铜。