
131 1300 0010

对于需要通过大电流的功率器件半导体,通常使用粗铝线楔形键合连接其电极和外部端子。该方法的特征在于,不形成焊球,直接将引线以楔形方式(或针脚键合)做二次键合,其程序如图4.3所示。将导线楔合到半导体上的焊盘上(第一键合点),在走线的同时形成线弧,并在外部端子侧的电极(例如基板)上进行第二键合点的键合,然后使用切割工具切断引线以完成整个键合过程,焊接参数包括超声波输出功率和压力、超声作用时间和频率等。在键合时,通过毛细管劈刀施加压力以使引线和电极变形,再加上超声振动,完成电线和电极的固相键合。
在楔形键合中,引线的键合方向与超声波的方向平行,以便在不使用焊球的情况下,增加键合面积并确保键合强度。与球形键合需要加热不同的是,楔形键合一般在室温下进行,这是由于线材的差别,用于楔形键合的铝在常温下也比较容易键合。
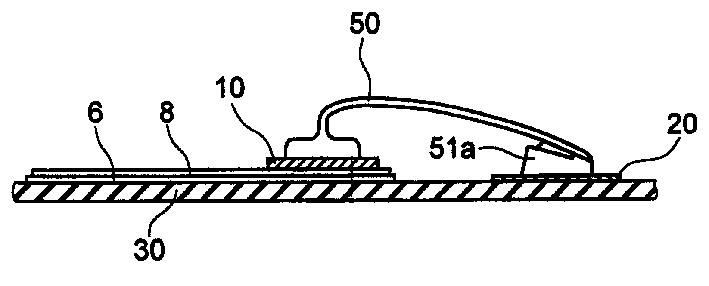
引线键合技术的分类
楔形健合 球形键合 $31
引线材料 铝 金 铜 覆钯铜
引线直径/μm 20~500 18~50 25~200 15-50
主要用途 功率半导体,
分立IC LSI高密度封装 后i
分立半导体 ISI半导体 LSI半导体,
就线径来说,功率器件应用需要大电流,因此使用线径为50~500μm的粗线。ISI半导体通常则使用线径为20~35μm的细线。此外,在最新移动设备的LSI半导体中,高密度封装迅速发展,越来越多地使用直径13~18μm的超细线。人们根据封装结构、应用和所需的性能等选择适当的键合线的形式、材料和尺寸。