

功率半导体的典型垂直封装结构如图所示。
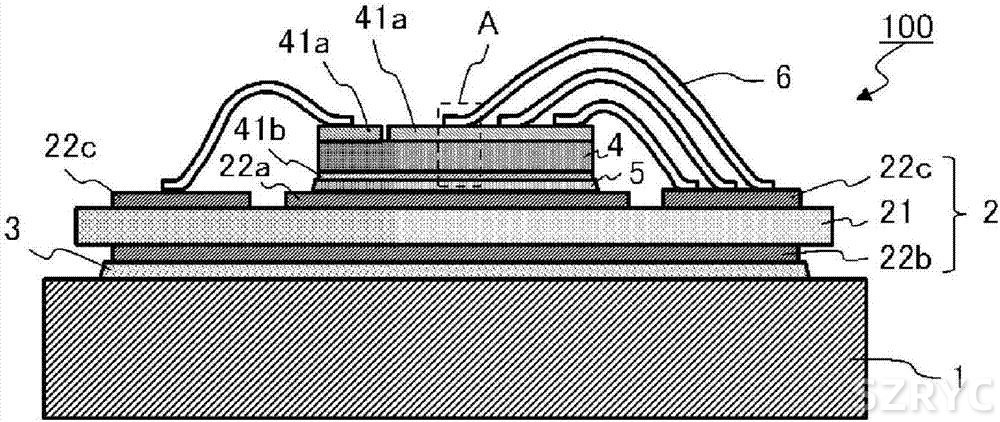
在Si或SiC的器件表面上完成接线,并通过芯片贴装向下释放半导体中产生的热量。目前,上表面的接线大多数是铝引线键合(见图),
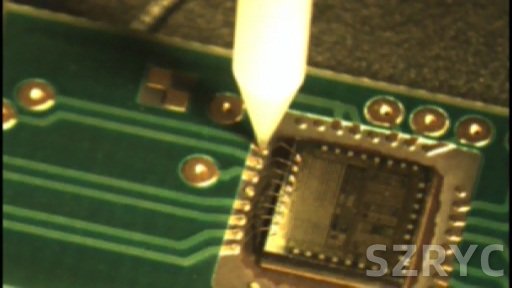
近来已经替换为横截面较大的条带键合,但是在条带键合工艺中减小压力是一个问题。另外,现已开发了电阻率较低的铜引线,但是其键合工艺压力比铝键合高也是一个问题。人们想要的是能带来低电阻的低压力引线键合线工艺。氮化(GaN)具有横向器件结构,但基本封装结构与图1.4相同。人们尤其希望硅上氮化具有成本竞争力,能很快形成市场。
模块散热是功率半导体中的一个技术问题。图2中所示的单面散热是用主流,但也有如图3所示电装公司的双面冷却类型。所有的贴装都需要异的热传导结构。目前缺乏可以令人安全放心使用功率半导体的通用可靠性估技术和标准,无法评估性价比的优劣。此外,即使是Si功率半导体也经常现应用故障,对于功率密度更高的碳化硅和氮化,没有经过考验切实可行可靠性技术是无法使用的,因此迫切需要为产业发展设立标准。
在功率半导体的可靠性方面,需要考虑的因素很多,但是与故障最直相关的是在功率循环中产生的退化损伤。需要注意芯片贴装部位的疲劳破坏陶瓷绝缘基板和结合界面的退化,或者引线键合界面的疲劳退化。尤其是芯片贴装处的空洞阻碍器件工作期间的散热,形成热点,成为失效原因,所以必须在生产时尽量避免。此外,随着工作温度升高,电流密度显著增加,因此必须充分注意电迁移对引线侧的影响。电迁移已经成为硅器件中的铝引线的主要问题,电迁移还会引起倒装芯片的精细焊接失效。尽管也有引起芯片贴装失效的情况,但是在芯片贴装侧还存在严重的应力载荷,使得
应力迁移和电迁移叠加作用。图1中显示的各个因素都是主要的器件性能退化机制。
宽禁带功率半导体的预期工作结温将超过200℃。这是当前硅封装技术完全没有涉及过的温度范围,并且模块的每个部件都要承受严酷的温度、应力和氧化/腐蚀性环境的考验,必然会增加发生故障的可能性,因此必须调整组成材料和器件结构。下面列出的是封装方面的要求:
1)可承受-50~300℃的严酷温度循环的组成材料和结合结构;
2)在250~300℃空气中抗氧化的界面设计;
3)阐明超高温大电流下的电迁移退化机制以及相应的结构设计;
4)包括模塑树脂的各种界面设计;
5)芯片贴装缺陷、引线/条带键合缺陷的检测和可靠性评价。
另外,读者应该注意到的是,当涉及模块时,功率半导体的封装技术还包括缓冲电容和电感的安装配置。由于本书内容着重于连线和散热,所以并未包含相关内容。