

摘要:针对倒装芯片(Flipchip)大功率发光二极管器件,描述了大功率LED 器件的热阻特性,建立了Flipchip衬底粘接材料的厚度和热导系数与粘接材料热阻的关系曲线,以三类典型粘接材料为例计算了不同厚度下的热阻,得出了Flipchip衬底粘接材料选择的不同对大功率LED的热阻存在较大影响的结论。
1 引言
1998年美国Lumileds Lighting公司封装出世界上第一个大功率LED (1W LUXOEN 器件),使LED器件从以前的指示灯应用变成可以替代传统照明的新型固体光源,引发了人类历史上继白炽灯发明以来的又一场照明革命。1W LUXOEN 器件使LED的功率从几十毫瓦一跃超过1000毫瓦,单个器件的光通量也从不到1个 lm飞跃达到十几个lm。大功率LED由于芯片的功率密度很高,器件的设计者和制造者必须在结构和材料等方面对器件的热系统进行优化设计。
目前GaN 基外延衬底材料有两大类[1]:一类是以日本“日亚化学”为代表的蓝宝石;一类是美国CREE公司为代表的SiC 衬底。传统的蓝宝石衬底GaN 芯片结构如图1 所示,电极刚好位于芯片的出光面。在这种结构中,小部分p-GaN 层和“发光”层被刻蚀,以便与下面的n-GaN 层形成电接触。光从最上面的p-GaN 层取出。p-GaN 层有限的电导率要求在p-GaN层表面再沉淀一层电流扩散的金属层。这个电流扩散层由N i和A u组成,会吸收部分光,从而降低芯片的出光效率。为了减少发射光的吸收,电流扩展层的厚度应减少到几百纳米。厚度的减少反过来又限制了电流扩散层在p-GaN 层表面均匀和可靠地扩散大电流的能力。
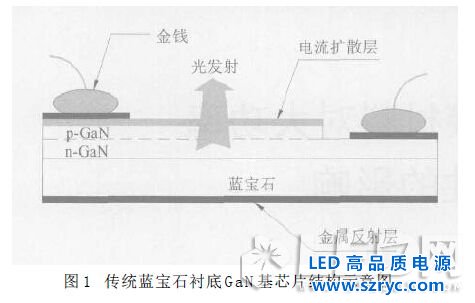
因此这种p 型接触结构制约了LED 芯片的工作功率。同时这种结构pn结的热量通过蓝宝石衬底导出去,导热路径较长,由于蓝宝石的热导系数较金属低(为3 5 W / m ·K ),因此,这种结构的L E D芯片热阻会较大。此外,这种结构的p电极和引线也会挡住部分光线进入器件封装,所以,这种正装LED芯片的器件功率、出光效率和热性能均不可能是最优的。为了克服正装芯片的这些不足,L u m i l e d s Lighting公司发明了倒装芯片(Flipchip)结构,如图2 所示。在这种结构中,光从蓝宝石衬底取出,不必从电流扩散层取出。由于不从电流扩散层取光,这样不透光的电流扩散层可以加厚,增加Flipchip的电流密度。同时这种结构还可以将pn结的热量直接通过金属凸点导给热导系数高的硅衬底(为1 4 5 W / m ·K ),散热效果更优;而且在p n结与p 电极之间增加了一个反光层,又消除了电极和引线的挡光,因此这种结构具有电、光、热等方面最优的特性。本文仅对蓝宝石GaN倒装芯片的衬底粘接材料对大功率LED器件热特性的影响进行分析。

2 基于F l i p c h i p的大功率L E D热分析
我们知道,表征系统热性能的一个主要参数是系统的热阻。热阻的定义为:在热平衡的条件下,两规定点(或区域)温度差与产生这两点温度差的热耗散功率之比。热阻符号:Rθ或 Rth;热阻单位:K/W或℃/ W一般倒装型大功率LED表面贴装到金属线路板,也可以再安装外部热沉,增加散热效果,其内部结构以及外部应用结构如图3所示[2,3]。
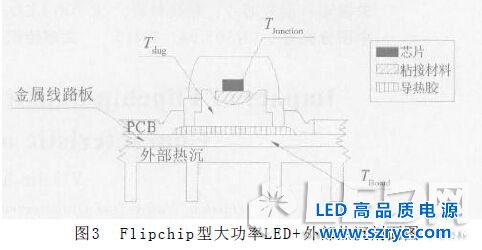
大功率LED芯片电极上焊接的数个BUMP(金球)与Si衬底上对应的BUMP通过共晶焊接在一起,Si衬底通过粘接材料与器件内部热沉粘接在一起。为了有较好的取光效果,热沉上制作有一个聚光杯,芯片安放在杯的中央,热沉选用高导热系数的金属材料如铜或铝。稳态时LED热阻的等效连接如图4所示。
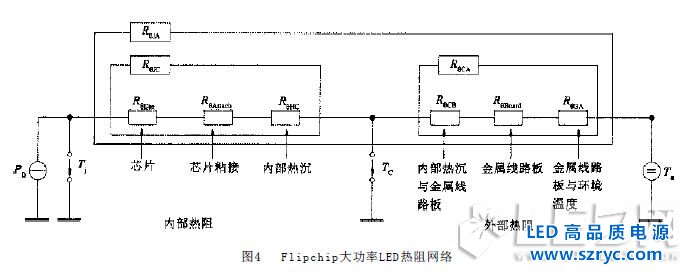
根据热阻的定义,可以得出

式中,Tj 、Ta ————分别对应LED 器件pn 结和器件周围环境温度;
R Θ JA —— LED 器件pn 结到环境温度之间的热阻;
PD ——器件的热耗散功率,在这里约等于器件的电输入功率,即PD = VF × IF。
根据热阻的运算性质,得出如下公式

式中,RΘJC ——器件的内部热阻;
RΘCA——器件的外部热阻。

式中,RΘDie —— 倒装芯片的热阻;
RΘAttach —— 芯片Si 衬底粘接焊料热阻;
RΘHC ——器件内部热沉的热阻。

式中,RΘCB——器件内部热沉与金属线路板之间的接触热阻;
RΘBoard ——金属线路板的热阻;
RΘBA ——金属线路板至环境温度之间的热阻。
3 衬底粘接材料对大功率L E D热特性的影响
L E D 倒装芯片被粘在管座(器件内部热沉)里,可以通过三种方式:导热胶粘贴、导电型银浆粘贴和锡浆粘贴。导热胶的硬化温度一般低于150℃,甚至可以在室温下固化,但导热胶的热导率较小,导热特性较差。导电型银浆粘贴的硬化温度一般低于200℃,既有良好的热导特性,又有较好的粘贴强度。锡浆粘贴的热导特性是三种方式中最优的,一般用于金属之间焊接,导电性能也非常优越。
在大功率LED 器件的封装中,生产厂家容易忽略衬底粘接材料对器件热导特性的影响。其实衬底粘接材料在影响器件热导特性因素中是一个比较重要的因素,如果处理不好,将使得LED 的热阻过大,导致在额定工作条件下器件的结温过高,导致器件的出光效率下降、可靠性降低。设倒装芯片衬底的横截面积为A (m 2 ),粘接材料的热导系数为λ(W / m ·K ),粘接材料的高度为h ( m ),则粘接材料的热阻为

下面我们以台湾国联光电公司的Flipchip为例进行分析。国联的芯片submount(衬底)是边长为55mil 的正方形,即A 为1.96 ×10-6m2。我们来分析热导系数为λ对粘贴材料热阻的影响。
当h= 2 0 μ m 时,则

当h= 4 0 μ m 时,则

当h=100 μ m 时,则

这三种情况的热阻与热导系数的关系曲线如图5所示。从图中可以看出,当选用铅锡焊料63Sn/37Pb ,λ =39W/m ·K ,同时其厚度等于20 μ m时,R θ Attach 等于0.026(K / W),即使其厚度为100 μ m,R Θ Attach 也只等于0.131(K/W);当选用热沉粘接胶Ablefilm 5020K,λ =0.7W/m·K,同时其厚度等于20 μ m 时,R ΘAttach 等于1.457(K/W),当其厚度为100 μ m 时,R Θ Attach 等于7.286(K / W ); 当我们选用导电型芯片粘接胶Ablebond 84-1LMISR4,λ =2.5W/m·K,同时其厚度等于20 μ m 时,R ΘAttach 等于0.408(K/W),当其厚度为100 μ m 时,R Θ Attach 等于2.041(K/W )。因此,选用不同的粘接材料对其热阻存在很大的影响,同时,在印刷或涂敷芯片粘接材料时,如何降低材料厚度也十分重要。
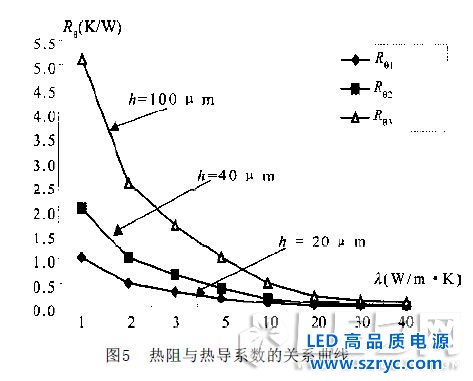
4 结语
LED 芯片结温最高允许125℃,如果其最差工作环境温度为65℃,则对一个1W 的大功率LED来说,考虑到从大功率器件外部热沉的热阻一般为40(K / W),器件p n 结至器件的热阻应小于2 0 (K /W )。而对一个5 W 的大功率L E D 来说,如果其最差工作环境温度为65℃,则从pn 结至环境的热阻要小于12 K/W才能保证芯片结温不超过125℃,而如果选用Ablefilm 5020K热沉粘接胶,λ=0.7W/m·K 同时其厚度为100 μ m ,仅芯片粘贴材料的热阻RΘ A t t a c h就等于7 . 2 8 6 (K / W )。因此,在Flipchip 大功率LED器件的封装中,选用合适的芯片衬底粘贴材料并在批量生产工艺中保证粘贴厚度尽量小,对保证器件的可靠性和出光特性是十分重要的。